根据Yole Developpement最新的数据,2020年至2026年,先进封装市场复合年增长率约为7.9%。到2025年,该市场营收就将突破420亿美元,这几乎是传统封装市场预期增长率(2.2%)的三倍。其中,2.5D/3D堆叠IC、嵌入式芯片封装(Embedded Die, ED)和扇出型封装(Fan-Out, FO)是增长最快的技术平台,复合年增长率分别为21%、18%和16%。
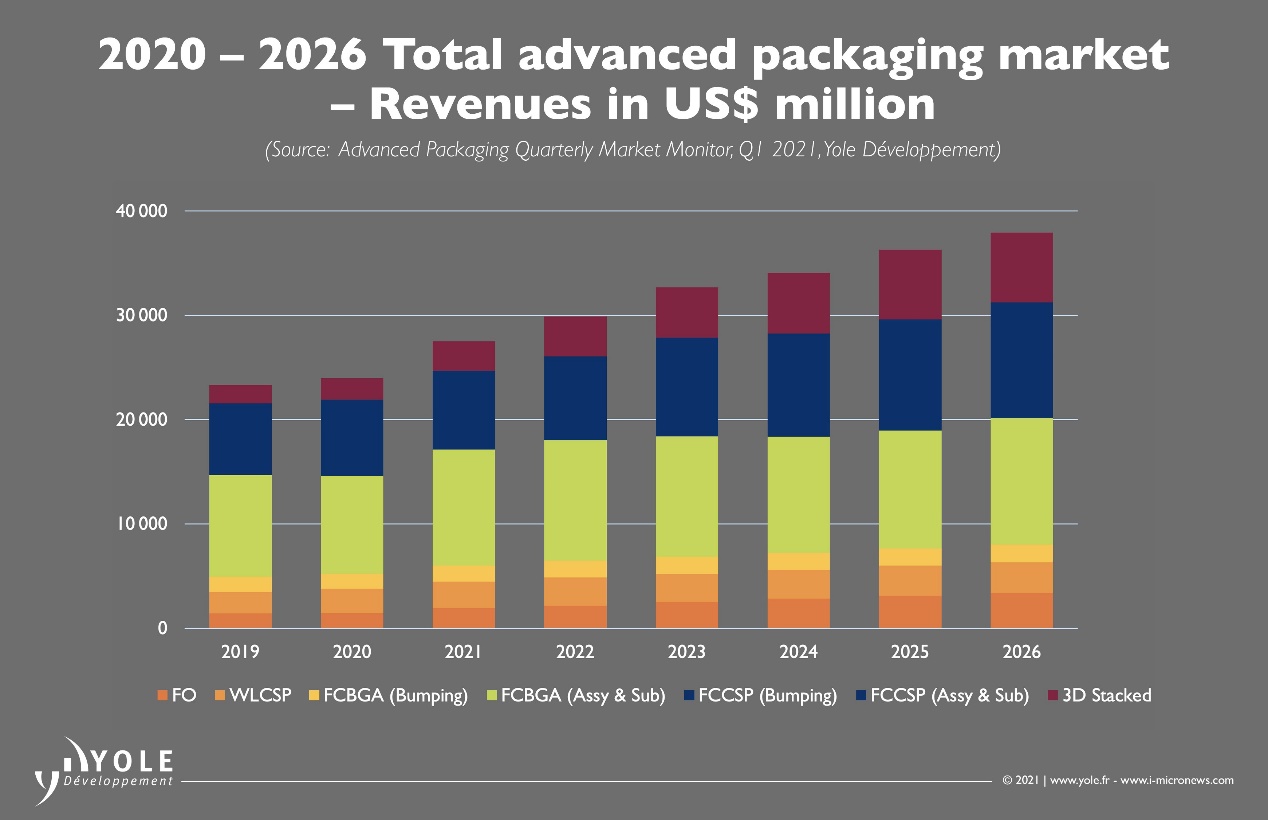
图片来源:Yole Developpement
全球芯片应用端的变化和转型无疑是推动先进封装产业高速发展的动力。
以汽车行业为例,以前的汽车系统普遍采用机械结构,几乎没有任何电子器件,而当今的汽车系统已经越来越由半导体和电子器件所定义。数据显示,在汽车“新四化”趋势的引领下,当前平均每辆汽车所需芯片数量已经从几年前的500-600颗迅速增加至1000-2000颗,成为成长率最高的芯片应用类别。
新能源汽车领域更是如此。在中国市场,随着电动汽车产业进入新一轮高景气周期,预计到2035年,中国xEV产量将占据全球的35%。相较于传统汽车,每台xEV所使用的芯片数量为传统汽车的4倍,作为核心器件的功率芯片比例与价值将超过整车的50%以上。
这其中,先进封装中的扇出型晶圆级封装(FOWLP)和扇出型面板级封装(FOPLP)就扮演着关键角色,它们被大量应用于汽车功率器件、传感器、通信和计算控制芯片中,以FOPLP/FOWLP技术所生产的车用芯片价值目前占一辆xEV汽车芯片含量总价值的77%。
除汽车外,5G、人工智能、数据中心、可穿戴设备、电源管理芯片(PMIC)、射频(RF)收发器、连接模块等各种应用也都在持续推动扇出型封装发展。其中,又以FOPLP技术更具成长潜力,Yole数据显示,2022年FOPLP的市场空间大约是11.8亿美元,预计到2026年将增长到43.6亿美元。
多元产业推动扇出型面板级封装发展
FOWLP与FOPLP技术都是异构整合了各类芯片,并将一些无源器件或功率器件嵌入其中,再以RDL互连形成一个小型化的解决方案。但两者各有千秋,各有适合的应用领域,非绝对竞争技术。
例如FOWLP技术面积使用率<85%,FOPLP面积使用率>95%,可以放置更多的芯片数,成本也比FOWLP便宜。数据显示,从200mm过渡到300mm大约能节省25%的成本,从300mm过渡到板级,则能节约66%的成本。
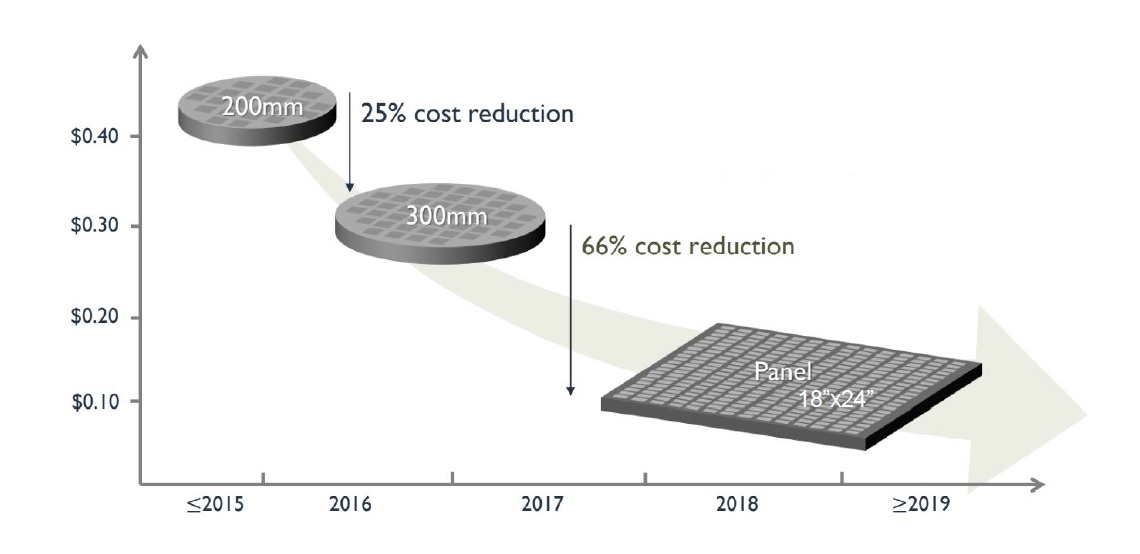
资料来源: Yole
应用层面,FOWLP适合高密度的扇出型封装,线宽更细,多采用代工厂较精密的制程和设备,应用于I/O数约300-1500个的APE、CPU、GPU、FPGA等大型芯片的生产;FOPLP聚焦在高功率、大电流的功率半导体产品应用,不需要最先进的制程和设备,也不需要太细的线宽/线距,应用于I/O数约10-500个的APE、PMIC、功率器件等芯片的生产。
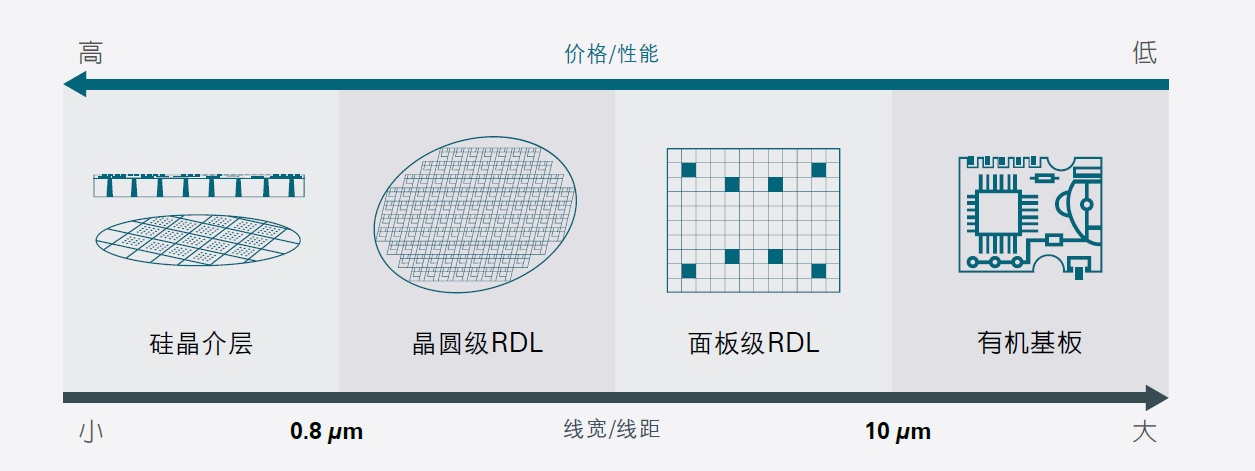
资料来源: Manz
在扇出型面板级封装的市场争夺中,半导体OSAT(外包半导体组装测试厂商)、IDM(集成器件制造商)、晶圆代工厂(Foundry)等来自不同领域的制造商都加入了其中,且斥资巨大。如下图所示,三星、日月光、力成科技、群创、华润微、奕斯伟、Nepes等都已切入扇出型面板级封装,他们的整体策略是向下游整合,以能提供整颗芯片封装完成为有利的商业模式。

但扇出型面板级封装发展还需要更多厂商,尤其是像PCB厂、载板厂、面板厂这些后段封装厂的协同努力。一方面有助于上述企业利用既有经验快速切入FOPLP技术,另一方面,前、后段半导体产业的共同投入也有助于寻找到最具竞争力的生产成本、提升产品竞争力的路径。
例如考虑到芯片、封装与PCB的同步设计及同步研发越来越重要,对PCB厂、载板厂来说,发展FOPLP的优势是通过制程知识和设备升级、改造,逐渐向前段制程跨进,快速跨入先进封装技术市场。
而对面板厂来说,以目前已量产的12寸(300mm)晶圆来看,可使用面积仅约为3.5代(620mm x 750mm)玻璃基板的15%。目前面板厂有许多竞争力低的3.5代产线,由于生产经济效益低落,藉由设备改造、升级加上原有的制程经验就可快速投入先进封装FOPLP。这将显著降低生产成本且减少资本支出,生产出具备竞争力的封装用RDL产品。
FOPLP突破业界最大生产面积
但无论是FOWLP还是FOPLP其实都面临一些关键挑战,例如合理布局到PCB上并实现高效的电气连接;形成高膜厚均匀性;高解析度的RDL等。尽管三星是第一家实现FOPLP量产的厂商,但总体来说,目前FOPLP的发展因受到良率产量、翘曲及设备投入研发、投资回报率等种种挑战,产业发展进程仍有待提高。
为此,德国厂商Manz(亚智科技)日前从FOPLP设备商的角度做出了有益尝试,宣布实现了FOPLP产业的一个重要里程碑——克服面板翘曲的挑战,成功生产出业界最大基板尺寸700mm x 700mm的面板。

Manz集团亚洲区总经理林峻生先生展示以Manz新一代板级封装 RDL自动化生产线所试生产的产品
Manz是板级封装RDL工艺的市场领跑者之一,在板级制程工艺、湿法化学工艺、自动化生产设备领域拥有三十多年的经验,自动化、量测与检测、激光制程、湿法化学工艺和工业喷印是其五大核心技术。
2016年Manz开始进军半导体先进封装领域,2017年研发并售出第一台用于半导体先进封装FOPLP的湿法化学设备,并于2019年交付首条半导体板级封装全自动RDL生产线,面板尺寸也从515mm x 510mm开始,演进至600mm x 600mm,直至最新的700mm x 700mm。
RDL铜重布线路层技术是扇出型面板级封装成败关键。官方资料显示,该生产线以大面积电镀制作精密的RDL层铜线路,克服电镀与图案化均匀度、分辨率与高度电气连接性的挑战,涵盖传统强项湿法化学工艺的洗净、显影、蚀刻、剥膜与关键电镀铜设备,同时实现全线的自动化生产。
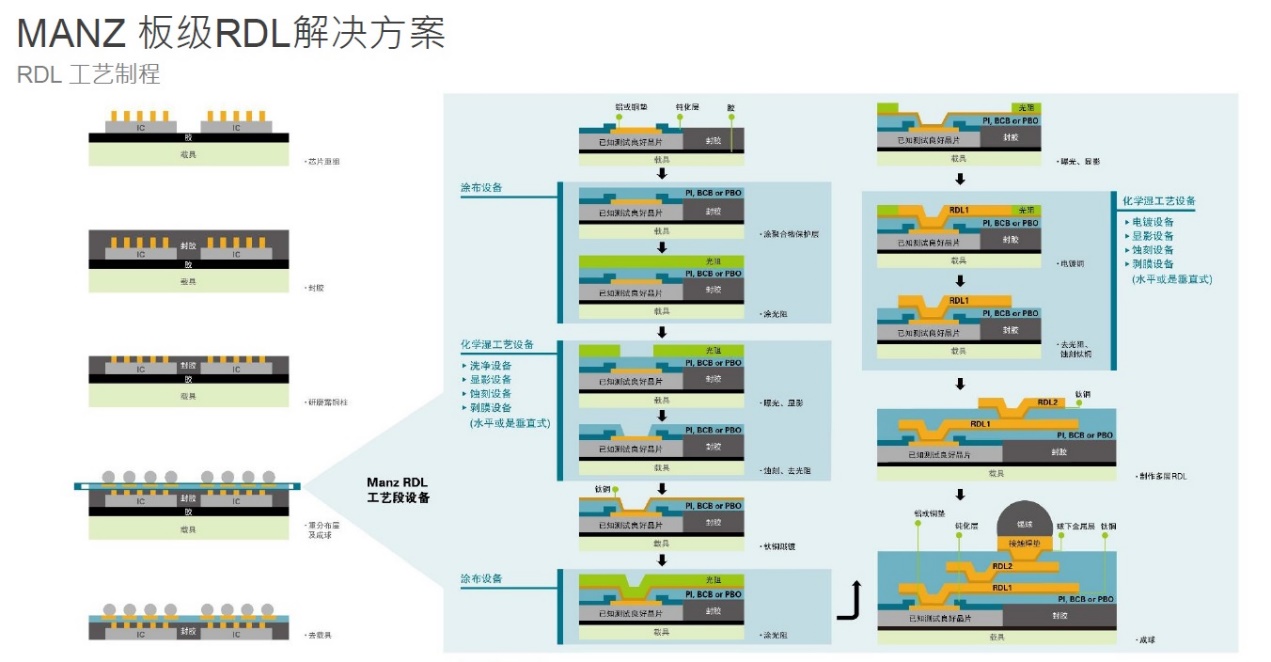
Manz创新杯式垂直电镀系统设计,是确保在大面积板级封装生产时,达成高均匀线路重分布层的关键。该设计无需笨重密封的阴极治具,多分区阳极(≥3)设计,能达成高均匀性电镀(U%≥90 %)。搭配无治具基板之高精度移载与上下板技术(≤±0.5mm),开发新移载架构,取代机械手臂,以缩小系统占地面积。再结合真空吸盘设计,无损基板且避免断电掉板之生产问题。
此外,Manz还积极整合材料商、上下游设备商,为客户提供完整的RDL生产设备及工艺规划服务,从自动化、材料使用与环保多维度协助客户打造高效生产解决方案并优化制程良率及降低制造成本。




 一览半导体芯片封装八大工艺
一览半导体芯片封装八大工艺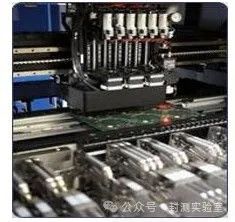 芯片封装测试:半导体产业背后的核心环节
芯片封装测试:半导体产业背后的核心环节 从封装到测试:半导体封测技术全面解析
从封装到测试:半导体封测技术全面解析 Nexperia扩充NextPower 80/100 V MOSFET产品组合的封装系列
Nexperia扩充NextPower 80/100 V MOSFET产品组合的封装系列






 慧聪电子网微信公众号
慧聪电子网微信公众号
 慧聪电子网微信视频号
慧聪电子网微信视频号

精彩评论