半导体封装是指将通过测试的晶圆按照产品型号及功能需求加工得到独立芯片的过程。封装过程为:来自晶圆前道工艺的晶圆通过划片工艺后被切割为小的晶片(Die),然后将切割好的晶片用胶水贴装到相应的基板(引线框架)架的小岛上,再利用超细的金属(金锡铜铝)导线或者导电性树脂将晶片的接合焊盘(Bond Pad)连接到基板的相应引脚(Lead),并构成所要求的电路;然后再对独立的晶片用塑料外壳加以封装保护,塑封之后还要进行一系列操作,封装完成后进行成品测试,通常经过入检Incoming、测试Test和包装Packing等工序,最后入库出货。
半导体生产流程由晶圆制造、晶圆测试、芯片封装和封装后测试组成。塑封之后,还要进行一系列操作,如后固化(Post Mold Cure)、切筋和成型(Trim&Form)、电镀(Plating)以及打印等工艺。典型的封装工艺流程为:划片 装片 键合 塑封 去飞边 电镀 打印 切筋和成型 外观检查 成品测试 包装出货。
半导体制造的工艺过程由晶圆制造(Wafer Fabr ication)、晶圆测试(wafer Probe/Sorting)、芯片封装(Assemble)、测试(Test)以及后期的成品(Finish Goods)入库所组成。
半导体器件制作工艺分为前道和后道工序,晶圆制造和测试被称为前道(Front End)工序,而芯片的封装、测试及成品入库则被称为后道(Back End)工序,前道和后道一般在不同的工厂分开处理。
前道工序是从整块硅圆片入手经多次重复的制膜、氧化、扩散,包括照相制版和光刻等工序,制成三极管、集成电路等半导体元件及电极等,开发材料的电子功能,以实现所要求的元器件特性。
后道工序是从由硅圆片分切好的一个一个的芯片入手,进行装片、固定、键合联接、塑料灌封、引出接线端子、按印检查等工序,完成作为器件、部件的封装体,以确保元器件的可靠性,并便于与外电路联接。
晶圆制造
晶圆制造主要是在晶圆上制作电路与镶嵌电子元件(如电晶体、电容、逻辑闸等),是所需技术最复杂且资金投入最多的过程。以微处理器为例,其所需处理步骤可达数百道,而且所需加工机器先进且昂贵。虽然详细的处理程序是随着产品种类和使用技术的变化而不断变化,但其基本处理步骤通常是晶圆先经过适当的清洗之后,接着进行氧化及沉积处理,最后进行微影、蚀刻及离子植入等反复步骤,最终完成晶圆上电路的加工与制作。
晶圆测试
晶圆经过划片工艺后,表面上会形成一道一道小格,每个小格就是一个晶片或晶粒(Die),即一个独立的集成电路。在一般情况下,一个晶圆上制作的晶片具有相同的规格,但是也有可能在同一个晶圆上制作规格等级不同的晶片。晶圆测试要完成两个工作:一是对每一个晶片进行验收测试,通过针测仪器(Probe)检测每个晶片是否合格,不合格的晶片会被标上记号,以便在切割晶圆的时候将不合格晶片筛选出来;二是对每个晶片进行电气特性(如功率等)检测和分组,并作相应的区分标记。
芯片封装
首先,将切割好的晶片用胶水贴装到框架衬垫(Substrate)上;其次,利用超细的金属导线或者导电性树脂将晶片的接合焊盘连接到框架衬垫的引脚,使晶片与外部电路相连,构成特定规格的集成电路芯片(Bin);最后对独立的芯片用塑料外壳加以封装保护,以保护芯片元件免受外力损坏。塑封之后,还要进行一系列操作,如后固化(Post Mold Cure)、切筋(Trim)、成型(Form)和电镀(Plating)等工艺。
芯片测试
封装好的芯片成功经过烤机(Burn In)后需要进行深度测试,测试包括初始测试(Initial Test)和最后测试(Final Test)。初始测试就是把封装好的芯片放在各种环境下测试其电气特性(如运行速度、功耗、频率等),挑选出失效的芯片,把正常工作的芯片按照电气特性分为不同的级别。最后测试是对初始测试后的芯片进行级别之间的转换等操作。
成品入库
测试好的芯片经过半成品仓库后进入最后的终加工,包括激光印字、出厂质检、成品封装等,最后入库。
7月18日报道,三星电机本月在韩国国内首次开始批量生产用于服务器的FCBGA。用于服务器、网络的FCBGA的基板面积是用于普通PC的FCBGA的4倍以上。
三星电机最近决定投资1.9万亿韩元的半导体封装基板(FCBG,倒装芯片球栅阵列)工艺。半导体封装基板的作用是传递半导体芯片和主基板之间的电信号,保护半导体免受外部冲击等。在半导体封装基板中,三星电机“专注于FCBGA”。主要用于PC和服务器等需要高性能、高密度电路连接的CPU(中央处理器)、GPU(图形处理器)等。
据报道随着第五代移动通信(5G)、云(Cloud)、人工智能(AI)技术的发展等,FCBGA等高规格产品在世界范围内呈现出需求剧增的趋势,但由于拥有技术能力的企业较少,目前市场处于供不应求的状态。韩国业内人士透露,预计2022年至2026年整体半导体封装基板市场将从113亿美元增至170亿美元,年均增长10%。其中,高规格半导体封装基板的年均增长有望达到15.7%。
2021年对于先进封装行业来说是丰收一年,现在包括5G、汽车信息娱乐/ADAS、人工智能、数据中心和可穿戴应用在内的大趋势继续迫使芯片向先进封装发展。2021年先进封装市场总收入为321亿美元,预计到2027年达到572亿美元,复合年增长率为10%。然而在先进封装这个市场中,中国封装企业不仅占据了主要的地位,还在去年迎来了强势增长。
全球TOP 30先进封装企业
Yole根据2021年封装业务的厂商市场营收作了排名,列出了前30的先进封装企业。如下图所示,在这30家企业中,中国OSAT厂商占据大半壁江山,再就是东南亚企业,日韩则相对较少。整体来看,前十大玩家占据了大部分的封装市场份额。
日月光继续主导市场,遥遥领先于其他竞争对手。安靠紧随其后,如果刨去IDM厂商英特尔和代工厂台积电,那么长电科技就排在第三位。除了长电科技,排名第七和第八的分别是大陆厂商通富微电和天水华天。这3家基本一直处于前十的地位,也较为人所熟知。
可喜的是,越来越多的大陆封测厂商已经开始逐渐崭露头角。我们可以发现,排在前30位的大陆先进封测技术的厂商还有第22名的沛顿科技、第28名的华润微以及第29名的甬矽电子。沛顿科技主要是进行高端存储芯片 (DRAM、NAND FLASH) 封装和测试服务,而且公司还在组建先进封装测试技术研发中心进行bumping/TSV等技术研发规划及布局。华润微的封装测试事业群覆盖了传统IC封装,功率器件封装,大功率模块封装,先进面板封装,硅麦&光耦sensor封装等。甬矽电子专注在模块封装(滤波器,射频前端模块(SIP),电源模块(PSIP)),球栅阵列封装(BGA)和Wifi,BT, 物联网(QFN)为主的高端IC封装测试。
在Yole的榜单上还有颀中科技(Chipmore)和晶方半导体。合肥颀中科技的封装业务覆盖显示驱动芯片、电源管理芯片、射频前端芯片等多类产品。晶方半导体主要是进行半导体CMOS图像传感器封装,技术有3DIC和TSV。
日韩在封测领域则相对处于弱势,前30家中仅有2家日本公司和1家韩国公司。TOP21是韩国企业LB semicon,成立于2000年2月,是韩国第一家在倒装芯片晶圆凸块领域开展业务的公司。提供的封装服务包括TFT LCD 和OLED显示驱动器IC (DDI) 的金凸块、倒装芯片凸块、焊料凸块、铜柱凸块,晶圆级芯片规模封装 (WLCSP)技术。TOP23是日本公司AOI ELECTRONICS,AOI提供用于IC/LSI的DFN/QFN、SOP/QFP、SON、SOT/SOC、DIP/SIP、BGA/LGA、FOLP等封装服务,以及用于传感器的开腔封装,和晶圆级WLP。TOP26的日本公司Nepes提供包括晶圆凸块、WLP 和 SiP 技术的完整的交钥匙解决方案。
当然还有很多未上市且正在先进封装领域耕耘的企业,如一站式芯片设计和供应链平台摩尔精英,目前已建有3家快封工厂,以工程批及小量产为主,在先进封装领域能提供SiP、FCBGA、FCCSP等先进封装技术。
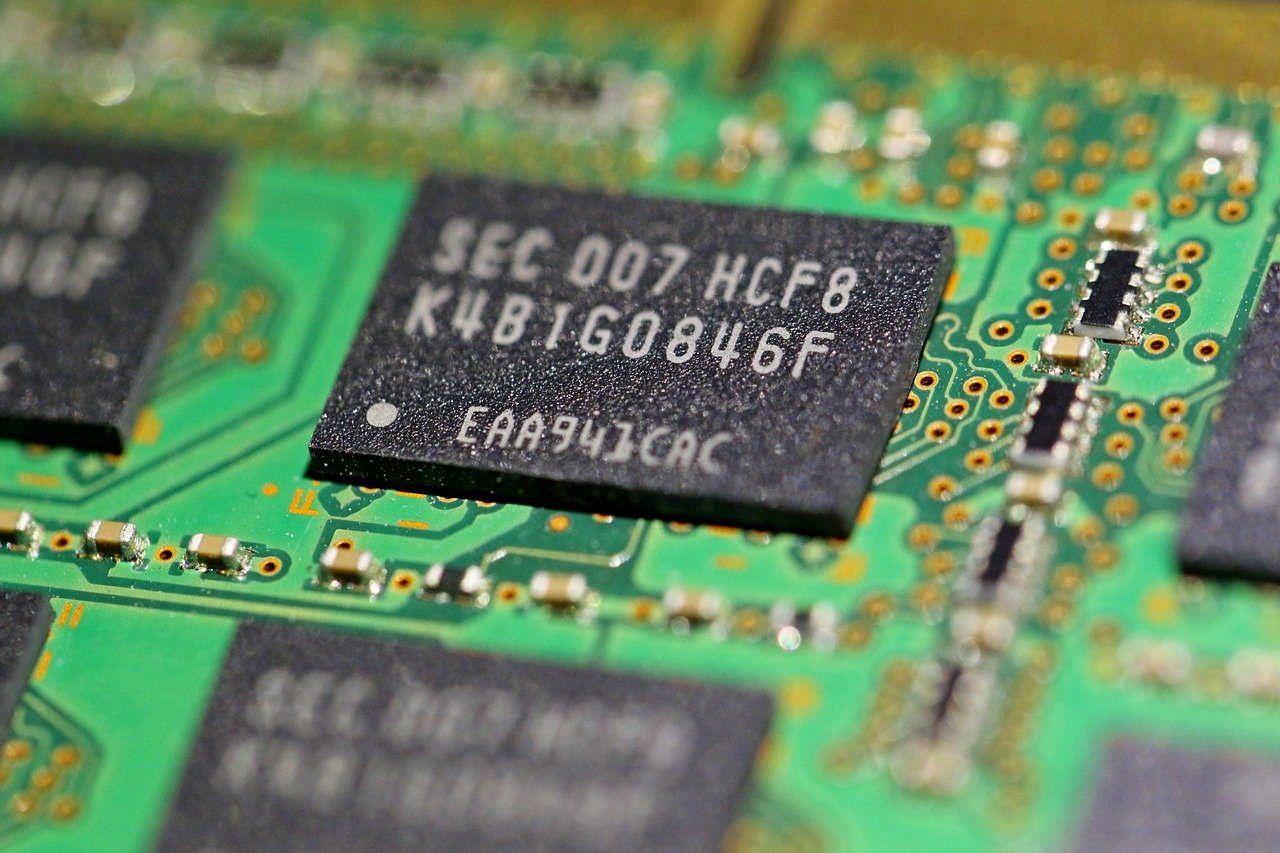
而不得不说,台湾的综合封测能力依然不容小觑,在前30家OSAT厂商中有13家是台湾的。他们分别是:
TOP6的中国台湾的力成科技(powertech),力成科技成立于1997年,2018 年,PTI 开始在新竹科学园区建设最新的扇出面板级封装制造工厂。TOP10的京元电子是全球最大的专业纯测试公司,为半导体生产的后端制程提供封测服务,在封装方面,京元电子提供BGA、QFN/DFN、TSOP、LGA、eMMC/ eMCP、存储卡/ MICRO SD 卡等的封装技术。TOP11是台湾的芯茂科技(ChipMOS),封装方面,为存储器、混合信号和 LCD 驱动器半导体提供全面的基于引线框架和有机基板的封装组装服务。TOP12是台湾的欣邦科技(Chipbond),欣邦科技是一家提供LCD驱动器从晶圆碰撞到封装后端组装处理的全套交钥匙服务的公司。驱动IC的制造工艺与标准IC不同,要求前端封装厂采用特殊工艺生产,后端采用金凸块、TCP或COF装配工艺生产。最后,它们被送到板房进行最终生产。TOP13是成立于1983年的台湾的超丰电子(Greatek),Greatek提供引线框架基础封装,包括P-DIP、SOP、SOJ、SSOP、TSSOP、MSOP、QFP、LQFP、TQFP、PLCC、TO等。而且,Greatek还正在积极进军堆叠芯片封装、MCM 和铜线生产。第14位是台湾的矽格股份(Sigurd),成立于1996年,为MEMS IC、电源管理IC、RF模块和逻辑 IC提供封装服务。Top 15的华泰电子(Orient),可为存储产品和和逻辑IC提供SiP封装服务。TOP19的同欣电子,成立于1974年,专注于厚薄膜基板与客制化半导体微型模组封装开发与生产制造技术。TOP20是台湾的欣铨(Ardentec),该公司主要提供晶圆级晶粒尺寸封装(Wafer Level Chip Scale Packaging)后段制程服务。TOP25是台湾福懋科技(FATC),FATC提供专业的LED芯片后端服务和封装服务。YOP30是华东科技(Walton),也是台湾企业,主要是专注在内存IC封装测试。
然后就是一些东南亚国家的OSAT,东南亚一直是封测产业的重镇,国内有不少OAST企业收购了马来西亚的封测厂而壮大了自己,但在前30名中仍有不少东南亚的OAST厂商。
TOP9是新加坡的一家独立的OSAT厂商UTAC ,成立于1997年,从内存测试和DRAM交钥匙测试和组装服务做起。2005年收购Ultra Tera Corp. (UTAC Taiwan) 以在台湾建立业务并增加存储设备测试和组装服务;2006年收购NS Electronics Bangkok (UTAC Thailand) 进军模拟组装市场;2014年收购松下在新加坡、马来西亚和印度尼西亚的3家工厂,进军汽车和工业终端市场。TOP16是泰国的华纳微电子(HANA Microelectronic),成立于1978年,最初只有30名员工组装LED(发光二极管)手表模块。1988年开始启动印刷电路板组装 (PCBA) 生产线。后来逐渐来到更高级的IC封装服务。TOP17是菲律宾企业SFA Semicon,它是韩国SFA集团旗下公司之一的SFA Semicon Co., Ltd.的子公司,母公司是三星的重要客户。TOP18是马来西亚公司Carsem,成立于1972 年,主要为SiC、5G倒装芯片、MEMS传感器提供封装服务。TOP24是马来西亚公司Unisem,提供晶圆凸块、晶圆探测、晶圆研磨、各种引线框架和基板 IC 封装、晶圆级 CSP 和射频、模拟、数字和混合信号测试服务。TOP27是马来西亚从事并提供DC和RF晶圆测试、晶圆背磨、晶圆锯切、引线键合、基板成型、基板锯切、芯片sip封装服务。




 资金紧张、难以为继!广州近30年PCB老厂遗憾停业
资金紧张、难以为继!广州近30年PCB老厂遗憾停业 首届码上掘金编程挑战赛获奖作品诞生:以「码上掘金」为马,让创意在指尖留存
首届码上掘金编程挑战赛获奖作品诞生:以「码上掘金」为马,让创意在指尖留存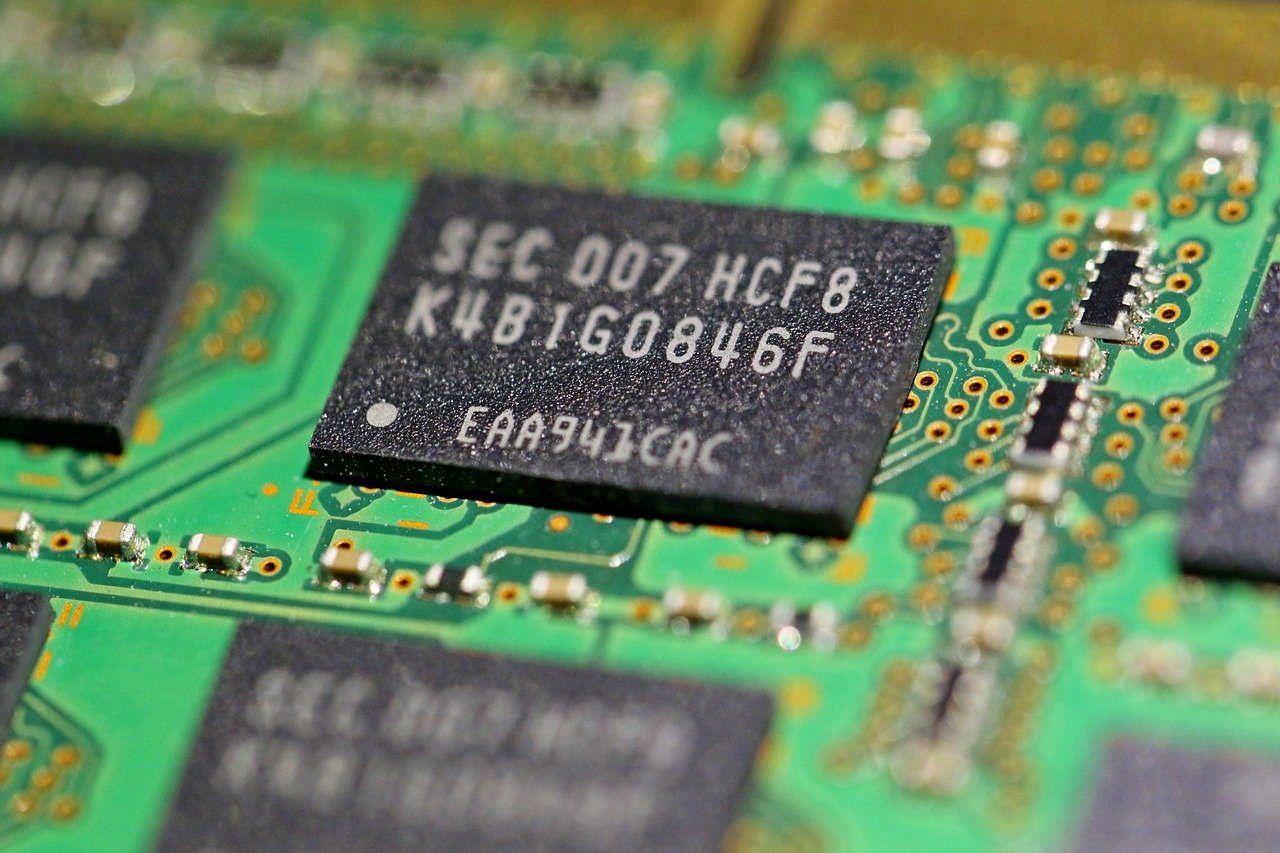 越来越多的大陆封测厂商已经开始逐渐崭露头角,哪些先进封装技术成为“香饽饽”?
越来越多的大陆封测厂商已经开始逐渐崭露头角,哪些先进封装技术成为“香饽饽”? 如何选择嵌入式产品中的存储器类型
如何选择嵌入式产品中的存储器类型






 慧聪电子网微信公众号
慧聪电子网微信公众号
 慧聪电子网微信视频号
慧聪电子网微信视频号

精彩评论