简介:
尽管半导体行业增速放缓,但先进封装产业2018年至2024年期间的年复合增长率仍高达8%,令人印象深刻。华进拥有成熟先进的晶圆级封装工艺(高密度凸块、扇入型晶圆级封装、扇出型晶圆级封装、硅转接板、直孔晶圆级封装)以及后道封装工艺(打线、倒装焊、系统集成)。
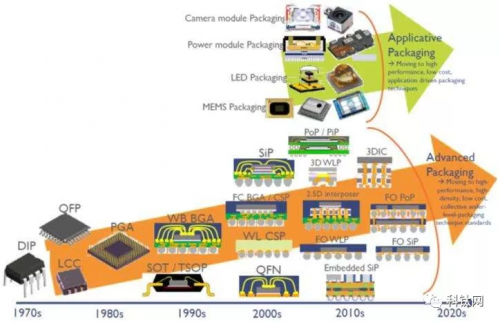
先进封装产业增势强劲
半导体行业正处于一个转折点。CMOS微缩放缓,成本不断上升,促使该行业依赖集成电路封装扩大后摩尔时代的利润。因此,得益于对更高集成度的广泛需求,摩尔定律放缓,交通、5G、消费电子、存储和计算、物联网(和工业物联网)、人工智能和高性能计算等大趋势推动下,先进封装已进入其成功的时期。
半导体行业经历了两位数的增长并在2017年和2018年收入创纪录;YoleDéveloppement预测2019年半导体行业将放缓增长(同比负增长)。然而,先进封装有望保持其增长势头,同比增长约6%。总的来说,先进封装市场将实现8%的复合年增长率,2024年市场产值达到440亿美元。相反,传统封装市场的同期复合年增长率仅2.4%,而集成电路整体封装业务的复合年增长率将为5%。Yole的《先进封装产业现状(2019年版)》探讨了先进封装领域,并年度综述了新的市场和技术发展情况。该报告首先总结了先进封装的驱动因素和新的市场动态,参考短期和长期路线图审视封装技术的发展,分析先进封装技术的趋势和挑战。此外,本报告还深入分析供应链,包括厂商定位、策略/产能、排名前25位的OSAT全面财务调查。后,报告总结了每个封装平台的收入、出货预测以及2018-2024年期间产能和潜在发展。

2018-2024年不同封装平台的先进封装营收预测
目前,倒装芯片占先进封装业务大头,但3DIC堆叠和扇出是发展快的先进封装平台。
2018年,倒装芯片占先进封装市场的81%左右;然而,到2024年,其份额将降至72%。在各先进封装平台中,3DIC堆叠和扇出的增长率都将达到26%,在各领域的应用将持续增长。基于TSV、混合键合或者两者组合的堆叠技术能实现其他任何技术都无法比拟的性能和集成度。3D存储(HBM和3DDDRDRAM)、基于2.5D转接板的晶粒分割和逻辑存储器集成引领高端TSV市场的增长。HBM业务在AI/ML、HPC以及数据中心的影响下高速增长。扇出封装被更多应用(BB、PMIC、RF、APE、存储)采用,同时渗透新的市场。事实上,随着不同商业模式的厂商进入市场,扇出封装市场有望实现更强劲的增长。在移动设备的主导下,扇入式WLP在2018-2024年间的复合年增长率将达到6.5%。嵌入式芯片虽然市场规模较小(2018年低于2500万美元),但在未来五年内,在电信、基础设施、汽车、移动设备等市场需求推动下,复合年增长率将达到49%。
在应用方面,2018年移动和消费电子占先进封装整体市场的84%。2018-2024年,该应用复合年增长率将达到5%,到2024年占先进封装市场的72%。在收入方面,电信和基础设施是先进封装市场增长快的细分市场(约28%),其市场份额将从2018年的6%增至到2024年的15%;与此同时,汽车和交通市场的份额将从9%增加到11%。

2018年先进封装应用的晶圆产量(按商业模式分类)
半导体供应链的变化、商业模式的转变以及与中美贸易的不确定性,为部分厂商创造了机遇,同时也对其他厂商构成了威胁。
在不断变化的商业环境中,半导体供应链正经历着不同层面的变革。一些厂商已经成功涉足新的商业领域,显著影响IC制造链,而其他人则未成功。不同的厂商有不同的驱动因素迁移或拓展新业务——例如谷歌、微软、Facebook和阿里巴巴这些软件公司正在设计自己的处理器,以便在组装层面获得系统级集成/定制和供应链控制。大的变化是代工厂涉足先进封装业务。尽管他们是该领域的新人,但带来的影响是显著的。台积电在扇出和3D先进封装平台方面处于地位,提供各种产品,如InFO(及其变种)、CoWoS、WoW、3DSoIC等。对于台积电来说,先进封装已经成为一项成熟的业务,预计2019年其先进封装业务的营收将达到30亿美元,在OSATs中排名第四。此外,UMC是2.5D封装硅转接板的主要供应商。UMC近与Xperi合作,为各种半导体器件优化并商业化ZiBond和DBI技术。同时,XMC为图像传感器和高性能应用提供了3DICTSV封装方案。总的来说,这些厂商有助于将封装从基板转移到硅平台。
IC基板和PCB制造商,如SEMCO、Unimicron、AT&S和Shinko,通过板级扇出封装和有机基板中的嵌入式芯片(无源元件)涉足先进封装领域,瓜分OSAT的市场,特别是涉及先进封装业务。为了保持竞争力,我们将看到未来几年OSAT行业出现很多并购交易:大企业合并、2家具有互补性业务的中型企业并购(如纯粹的封装测试厂商之间)和大企业收购小规模的OSAT(或晶圆级封装企业)。像DecaTechnologies和LBSemicon这样的利基WLP厂商是具吸引力的并购对象。
美国和中国之间的贸易紧张局势可能会影响半导体行业的增长,给供应链带来不确定性。目前,情况仍然不明朗,有很多可能。这取决于是否爆发全面贸易战,或者是否达成新的贸易协议,或者双方都做出让步,亦或维持现状。这场贸易战也有可能导致组装供应链从中国大陆转移到台湾、韩国和东南亚。
封装和组装曾经是OSAT和IDM的传统领域,如今却出现了范式转移。来自不同商业模式(晶圆厂、基板/PCB供应商、EMS/DMs)的厂商正在进入并蚕食OSAT的市场份额。本报告总结了这些供应链的变化及其影响,每个先进封装平台都列举了至少25家主要封装供应商的生产情况。对财务业绩的深入了解帮助我们整体把握技术发展、供应链转移和厂商运营情况之间的关联性。这份报告介绍并深入分析了2013-2018年间排名前25位的OSAT厂商的财务状况;还研究了中美贸易战及其对半导体供应链(包括组装和封装)的潜在影响,并考虑是否会出现的明确赢家/输家局面。
排名前25位的OSAT




 观众火热报名中!同期活动亮点纷呈,ES SHOW 2025深圳元器件展10月28-30日邀你共鉴!
观众火热报名中!同期活动亮点纷呈,ES SHOW 2025深圳元器件展10月28-30日邀你共鉴! 品英Pickering为光电信息领域提供先进的开关、仿真方案和测试系统
品英Pickering为光电信息领域提供先进的开关、仿真方案和测试系统 品英Pickering公司仿真方案和测试系统满足航电设备可靠性和安全性等更高要求
品英Pickering公司仿真方案和测试系统满足航电设备可靠性和安全性等更高要求 台积电先进封装订单激增,消息称英伟达独揽七成产能
台积电先进封装订单激增,消息称英伟达独揽七成产能






 慧聪电子网微信公众号
慧聪电子网微信公众号
 慧聪电子网微信视频号
慧聪电子网微信视频号

精彩评论